探针测试后检测

精准检测与量测探针测试导致的损伤
多数晶圆需经过测试环节,对每个器件(或称芯片)进行电性测试以确保其功能正常。该过程通过探针卡上的探针阵列与芯片输入/输出端口发生物理接触来实现电性测试。而探针与芯片的实际接触可能造成一定损伤。
Camtek提供先进的检测与量测解决方案,用于发现和测量晶圆探针测试过程中造成的损伤。我们的解决方案旨在检测各类影响器件质量的关键缺陷,同时提供增强生产效率和产品良率所需的分析数据。
我们的探针测试后检测方案是通用表面检测产品线的重要组成部分,专为支持大规模量产环境而设计。

核心能力
- 微细钝化层裂纹检测
- 已测试bump损伤检测
- 探针工艺问题检测与量测,包括:探针标记位置偏移、探针标记尺寸异常
- 先进分析工具,含独家3D传感器,支持探针标记深度分析
- 满足100%全检要求的高吞吐量
- 多种统计分析图表,支持工艺控制与数据分析

核心技术
- 用于缺陷检测与量测的先进处理引擎
- 高分辨率3D共聚焦传感器与白光干涉仪
- 探针标记尺寸、相对位置及异常特征的统计分析
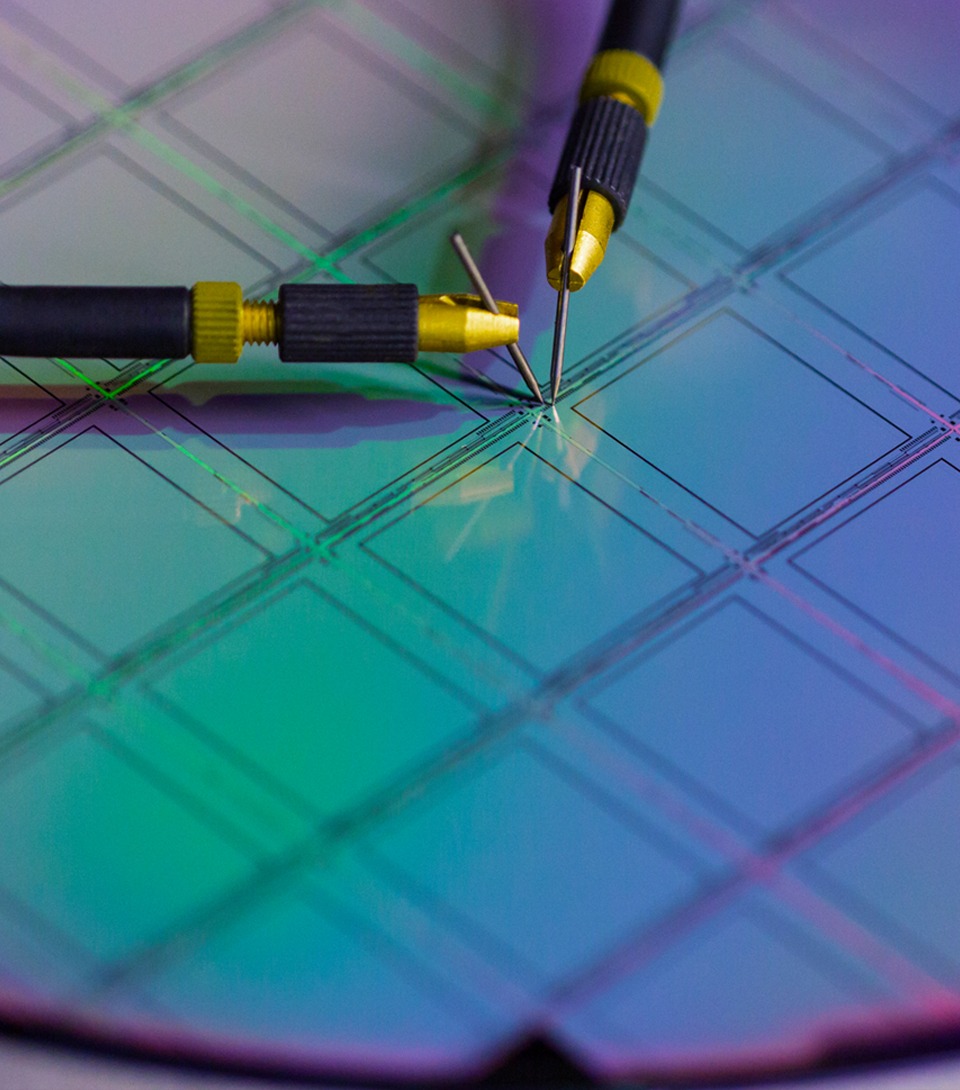
产品










