扇出型封装

应对扇出工艺挑战的专属检测与量测方案
晶圆级扇出与板级扇出封装技术,旨在为单芯片及多芯片应用提供更多的I/O布设空间,同时缩小封装尺寸与厚度,并实现更低的成本。
更小的尺寸、更密更多的再布线层以及更微小的缺陷,使得扇出封装的检测面临严峻挑战。此外,对扇出型重构晶圆上芯片偏移的量测,是光刻、电镀等后续工艺步骤所必需的关键输入。
Camtek的技术提供了专属的检测与量测能力,能够有效应对高难度的扇出工艺,特别是使我们的系统能够检测线宽/线距低至2微米的RDL结构。
我们的系统具备全面的表面检测能力,并能追踪关键的专属量测数据,用以监控芯片的放置精度与层间对准情况。同时,我们还提供了先进的解决方案,专门用于处理翘曲晶圆的传输与测量。
Camtek系统所提供的基于计算机辅助设计的检测技术,可将重构晶圆上芯片的采集图像与制造晶圆所用的CAD数据进行比对。以CAD数据为基准来检测重构晶圆,有效解决了可能产生的对准难题。
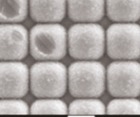
核心能力
- RDL检测与量测
- 多层RDL检测
- 适用于所有工艺步骤与缺陷类型的多光学配置
- 3D高度与共面性测量
- 芯片偏移与旋转量测
- 基于CAD的检测

核心技术
- Camtek独家白光三角测量传感器
- 用于缺陷检测与量测的先进处理引擎
- 高分辨率3D共聚焦传感器
- 用于3D量测的光干涉技术
- 清晰视野成像技术,支持多层RDL中的顶层检测
- 基于CAD的检测技术

产品













